-
近红外光谱分析技术在现代农牧业、食品安全、生物医药、石油化工、环境监测、航空航天等领域都有非常重要而广泛的应用[1-5].作为近红外光谱分析检测仪器的微型近红外光谱仪,本身具有体积小、质量轻、探测速度快、性能稳定、可集成化、可批量化制造以及成本低廉等优点,与传统的近红外光谱仪相比有巨大差别和优势,必然会成为国内外近红外光谱仪的研发方向与主流趋势.而光栅是低成本、高性能微型近红外光谱仪的核心器件.微型近红外光谱仪精度、灵敏度等关键问题主要取决于光栅的衍射效率与分辨率等关键技术.
光栅的传统制作方法有机械刻划法、全息干涉法、真空镀膜复制法等[6].随着微机电系统(MEMS)技术的发展与日趋成熟,基于MEMS技术的光栅具有体积小、功耗低、成本低、可批量制造等优点,成为MEMS技术的研究热点之一.闪耀光栅作为衍射光栅的一种,具有很高的衍射效率和光谱分辨力,成为实用衍射光栅的主要类型.以往在进行闪耀光栅的设计与分析时,往往都将闪耀光栅的槽形看作标准的三角形[7-9],但这并不符合采用掩膜线进行湿法刻蚀制作MEMS光栅的实际情况.因为掩膜线的宽度不可能做得无限窄,经过湿法刻蚀之后,光栅的顶端总会留有一个小平台,该小平台使得光栅衍射面不连续,从而降低了光栅的衍射效率.所以在进行光栅设计时,应该考虑该平台对光栅衍射效率的影响.
本文针对光谱范围为800~1 800 nm的微型近红外光谱仪,利用偏晶向(111) 硅片,设计并制作了闪耀角为8°、周期为4 μm的近红外闪耀光栅.器件测试表明,以偏晶向(111) 硅片作为基底材料的MEMS光栅,具有良好的光学反射率和镜面平整度,从而具有较高的衍射效率,能满足微型近红外光谱仪的使用要求.
全文HTML
-
进行闪耀光栅设计时,要决定的参数主要有光栅闪耀角和光栅周期.光栅闪耀角由闪耀波长和光栅周期决定,用公式表示为
其中,θ为光栅闪耀角,d为光栅周期,λb为闪耀波长.闪耀波长可以根据光谱工作范围来决定,计算的经验公式为
其中,λmin为波长范围的下限,λmax为波长范围的上限.本文的光栅是为光谱范围为800~1 800 nm的微型近红外光谱仪设计的,由(2) 式可计算出光栅闪耀波长为λb=1 050 nm.光栅周期直接决定了光栅的可用波长范围.当光栅闪耀角保持不变时,光栅周期越大,则工作波长越长.综合考虑光栅的工作范围、光栅分辨率、光栅的闪耀角度等,该光栅的光栅周期设为4 μm(即光栅刻线为250线/mm).根据光栅的闪耀波长和光栅周期,由公式(1),即可计算出光栅的闪耀角为θ=7.54°
如果光栅槽形为标准的三角形如图 1所示,d为光栅周期,θ为光栅闪耀角,b为光栅闪耀面宽度,对周期为4 μm、闪耀角为7.54°的光栅用Pcgrate软件进行衍射效率仿真,结果如图 2所示.从图中可知,在800~1 800 nm的光谱范围内,光栅的平均衍射效率在50%以上,最高点的衍射效率能达到90%.
但是,实际的光栅槽形并不是标准的三角形(图 3),其顶端有一掩膜线留下的平台(称为脊,其宽度用a表示),该平台使得光栅衍射面不连续,且减小了光栅闪耀面的宽度,从而降低了光栅的衍射效率.根据目前国内掩膜线制作的工艺水平,掩膜线最小线宽可为1 000 nm.为此,我们对闪耀角为7.54°、脊宽为1 000 nm的非标准三角形光栅进行衍射效率的仿真,结果如图 4所示.从图中可以看出,该光栅相比标准三角槽形光栅,衍射效率下降了,尤其在长波方向的衍射效率下降得较多.故在进行光栅设计的时候,必须考虑光栅顶端平台对衍射效率造成的影响,应对光栅的闪耀角7.54°进行修正.
为了提高长波方向的衍射效率,需要增大光栅的闪耀角度.根据目前硅片生产厂家的加工条件,偏晶向(111) 硅片的最大切偏角(该角即为光栅的闪耀角)为8°,为此我们拟定光栅的闪耀角度为8°.在MEMS光栅制造的过程中,可以通过MEMS的氧化工艺减少光栅的脊宽.为此,我们对闪耀角度为8°的光栅在不同脊宽下进行衍射效率仿真,并与闪耀角度为7.54°的光栅在同等脊宽下进行衍射效率对比,结果如图 5所示.
从图 5中可以看出,在光栅脊宽大于400 nm时,8°闪耀角光栅和7.54闪耀角光栅相比,在短波方向的衍射效率有所下降,但衍射效率值还是较大,均在56%以上,而在长波方向明显提高了光栅的衍射效率,且在整个光谱范围内的最低衍射效率高于7.54°闪耀角光栅的最低衍射效率.实际的MEMS氧化工艺,很难将光栅的脊宽减到400 nm以下.因此,在光谱范围800~1 800 nm内,8°闪耀角光栅的衍射效率优于7.54°闪耀角光栅,最终确定光栅的闪耀角度为8°.
-
为了制作闪耀光栅,在制作硅片时,需要将(111) 硅棒以[1 10]晶向为轴,相对于标准(111) 面偏转一个角度进行切割,该角度就等于光栅的闪耀角.光栅可以利用UV光刻和各向异性湿法刻蚀来实现,如图 6所示.制作好的硅片在TMAH(四甲基氢氧化铵)等碱性溶液中腐蚀时,不带SiO2掩膜的硅表面将向下刻蚀,当两个(111) 面相交时刻蚀自停止,这样就得到了三角槽形的闪耀光栅.用这种方法,选择合适的硅片切偏角,即可方便地实现想要的闪耀角,且光栅表面的光滑度可以由晶面来保证[10-13].
利用掩膜线进行湿法刻蚀制作的闪耀光栅,在光栅的顶端总会留有一个小平台.对于这个平台,P.Philippe[11]利用硅的各向同性湿法刻蚀来去除,但这种方法容易造成光栅顶部变圆,并且各向同性刻蚀同样会对闪耀面进行腐蚀,从而增加闪耀面的粗糙度.李四华通过重复氧化削尖工艺来去除光栅面的平台[14],由于光栅凸角处的氧化速率比光栅面的氧化速率快,这种方法在多次氧化的过程中也会使光栅顶部变圆.本文采用的方法为:硅片经过各向异性湿法刻蚀后,不去除顶端的氧化硅掩膜,然后进行一次氧化,直到氧化不能进行为止.由于光栅顶部覆盖有作为掩膜的氧化硅,氧化从两个(111) 面向掩膜线的下方进行,从而使光栅顶端平台变窄,如图 7所示.由于氧化只在(111) 面进行,该方法并不会造成光栅顶部变圆,不会破坏光栅面的平整度,但是氧化生成的氧化硅覆盖在硅表面,会阻碍氧化的进一步进行,所以氧化到一定时间就会停止,光栅顶端的平台不能完全消除.
光栅制作的工艺流程如图 8所示. (a)选取厚度为500 μm、偏离(111) 硅晶面8°切割的n型(111) 硅片作为基底,并把表面抛光; (b)在硅表面热氧化生长150 nm厚的SiO2薄膜; (c)在SiO2薄膜上涂覆光刻胶,经光刻、显影后,用HF酸去除裸露的SiO2薄膜,释放出光栅光学工作面的图形,然后去胶; (d)用浓度为25%的TMAH溶液,对硅片进行各向异性湿法刻蚀.当两个(111) 面相交后腐蚀就会自停止,形成三角形的光栅槽形; (e)把经过刻蚀的光栅放入氧化炉中氧化4 h左右,生长SiO2薄膜; (f)用HF酸溶液去除光栅表面的SiO2层,就得到了三角形的光栅槽形.最后一步,在光栅表面镀上一层金,以提高光栅的反射效率.
对制造的光栅样片用扫描电子显微镜(SEM)进行测试,结果如图 9所示.从图 9(a)上可以清晰看到光栅具有平滑的光学表面和良好的光栅槽形. 图 9(b)显示了光栅参数的测试结果:光栅周期为4.025 μm、光栅平台宽度为555.4 nm,最大凹槽深度479.0 nm.从测试结果可以看出,光栅样片的刻槽形状与设计的结果一致.
-
衍射效率是光栅最重要的性能指标,它反应了光谱仪器的能量特性.衍射效率有绝对衍射效率和相对衍射效率.对于反射式光栅,通常测量其相对衍射效率,相对衍射效率是指在给定波长和光谱级次的情况下,光栅的衍射效率能量与一块具有与光栅相同孔径并且镀有与光栅相同膜层的反射镜反射同一波长时的能量之比.即
其中,E光栅(λ,k)(k=0,±1,±2,……)是波长为λ的k级衍射光的能量; E反射镜(λ)是波长为λ的反射光的能量.
光栅衍射效率的测试原理如图 10所示.半导体激光器发出的光经准直后入射到MEMS光栅(或参考反射镜)上,经光栅衍射(或反射镜反射)后,进入光功率计,辐射强度被光功率计所探测.
实验测试装置如图 11所示.实验中使用了波长为1 392 nm的近红外激光器作为光源.由于光栅具有极强的偏振效应,因而在测试的过程中,注意光栅刻槽方向与激光的偏振方向相匹配,即偏振光的电矢量应垂直于光栅刻槽[6].激光入射到光栅上时,应当通过三维调节架对光栅和光功率计的探头进行调节,使光栅处于最佳位置处时,光功率计上衍射光的强度能够准确的达到最大值.
表 1列出了激光波长为1 392 nm时各级次的衍射效率.受探测器装置的限制,未能探测到正级次的衍射光. -2级次以下的衍射光可以探测到,但是由于能量太低,淹没在噪声之中了.从测试结果可以看出,光栅的-1级衍射效率明显比其他级高出许多,说明光的大部分能量都被集中衍射到-1级次上,此光栅具有很好的闪耀特性.
在1 392 nm入射波长点,对光栅衍射效率的仿真值和实测值进行比较,结果如表 2所示.可以得知,光栅样片衍射效率的仿真值和实测值吻合良好.对-1级衍射光,误差只为8.6%.
-
MEMS光栅是低成本、高性能微型近红外光谱仪的核心器件.本文利用硅的各向异性湿法腐蚀性质,在偏晶向(111) 硅基底材料上制作了闪耀角为8°、周期为4 μm的近红外闪耀光栅.由于光刻掩膜线的宽度不可能做得无限窄,经过湿法刻蚀之后,光栅的顶端总会留有一个小平台.本文在进行光栅设计时,考虑了光栅顶部平台对光栅衍射效率的影响,对光栅的闪耀角进行了修正.并提出了一次性氧化削尖的方法,在光栅制作时减少光栅顶部平台的宽度,增加光栅的闪耀面,改善闪耀光栅的衍射效率.最后对光栅进行了衍射效率测试,当入射波长为1 392 nm时,衍射效率能达到70%以上.实验结果表明,此光栅具有很高的衍射效率,能满足光谱范围为800~1 800 nm的微型近红外光谱仪的使用要求.



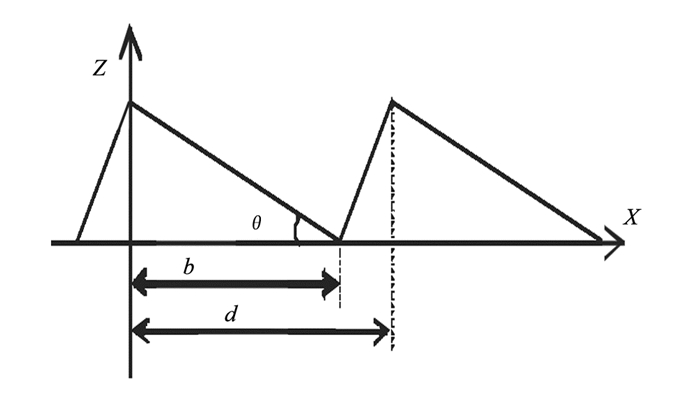
 下载:
下载: