-
1.3~1.55 μm波段对应着石英玻璃光纤的低色散低损耗窗口,这一波段的激光器和探测器是光纤通讯系统最核心的光电子器件.而目前光纤通讯中使用的1.55 μm光电子器件仍主要为InGaAsP/InP量子阱激光器,由于InGaAsP/InP的导带带阶小,使其器件温度特性较差,为改善其温度特性所需的工艺代价较大.量子点(线)材料由于其δ函数型的态密度使其有着比量子阱器件更优的特性,这已在GaAs基量子点材料体系中得到了很好的体现:如低的阈值电流和高的特征温度等[1-3].因此,有关1.55 μm InP基InAs量子点(线)材料及其激光器的研究成为人们广泛研究和探索的对象.
但由于InAs/InP的失配度较低、InAs各向异性的应力弛豫[4]、InAs与缓冲层之间的可能的合金化[5]及外延过程中缓冲层强烈的相分离[6]等原因,使得InP衬底上纳米结构的形成机制非常复杂.量子点尺寸和分布的均匀性问题也是一个很大的问题,量子点的不均匀性直接影响了量子器件性能[7-9],比如由于尺寸和分布不均导致的发光峰宽、发光峰位随温度红移、发光强度随温度淬灭等.因此,为了更好地利用低维结构的光学和电学性质,提高器件性能,必须深入研究InP基材料的生长机制,进而实现通过改进生长条件来达到优化结构和改善材料性能的目的.
MBE法生长III-V族材料时,As压是一个非常关键的因素,它的大小影响Ⅲ-Ⅴ族材料的表面再构,从而影响InAs纳米结构的尺寸、形状和分布,进而影响纳米结构材料的光学和电学特性.本研究主要分析不同周期的As压调制的InAlAs超晶格对InAs/InAlAs/InP纳米结构材料光学特性的影响.
全文HTML
-
图 1为本研究设计样品的基本结构,4个样品分别含有0,2,4,6个周期的As压调制的InAlAs超晶格.所有的样品都是在固源分子束外延(MBE)系统中进行.衬底全部采用半绝缘InP衬底,生长过程中钼托高速旋转以增加样品生长的均匀性.
具体生长过程为:首先脱去衬底氧化层,然后依次是:300 nm的InAlAs缓冲层,As压调制的InAlAs超晶格,对于4个样品(G288,G289,G226和G225) 超晶格周期数分别为0,2,4,6,其中每个超晶格周期含有2 nm的缺As的InAlAs和2 nm富As的InAlAs层,缺As的InAlAs层生长As压为9.4×10-5 Pa,富As的InAlAs层生长As压为5.4×10-4 Pa,其他生长条件两层保持一样.然后是4ML的InAs层,最后是200 nm的InAlAs盖层.为了原子力测试,盖层表面上再沉积4ML的InAs.整个生长过程中,InAlAs层的生长温度为510 ℃,InAs层生长温度为500 ℃.在InAs生长前后10秒的生长停顿是为了稳定表面.
-
图 2为4个样品表面典型的1 μm×1 μm原子力显微镜像,由图 2中可以清楚地看到,随As压调制的InAlAs超晶格周期数的增加,InAs纳米结构形貌发生了很大的变化. 0个周期的InAlAs超晶格也就是在传统的InAlAs缓冲层上生长InAs时形成沿[-110]方向延长的量子线;InAlAs超晶格的周期数增加到2时,形成了沿[-110]方向延长的量子线和量子点的混合结构;4个周期时,观察到了椭圆型的量子点,椭圆的长边沿[-110]方向;最后,当进一步增加InAlAs超晶格的周期数到6时,我们观察到了圆型的、尺寸分布均匀的、高密度的InAs量子点.文献[10]从理论上解释了引入As压调制的InAlAs超晶格后,生长的自组织InAs纳米结构的成核和形貌演化机制.我们认为,InAs纳米结构的最终形貌主要由InAlAs层的表面相分离引起的各向异性应变分布和In吸附原子的各项异性扩散所决定.
图 3为4个样品室温光致发光谱(PL),样品光学性质的表征在IFS 120 HR傅里叶变换红外光谱仪上光源为Ar+离子激光器的514.5 nm谱线,探测器为InGaAs.对应于0,2,4,6个周期样品的PL谱的峰位分别为:1.381,1.576,1.560,1.529 μm.同时,在0个周期时PL谱低能边有一峰,高斯拟合后显示中心峰位为1.432 μm.考虑到量子点的垂直高度远小于其横向尺寸,量子限制效应主要由垂直方向上的高度所决定,即PL谱的发光峰位主要决定于量子点的高度[11].因此,1.432 μm应该为高度较大的量子线发光. 4个样品的室温辐射效率被估算,分别为1.2×10-4,1.63×10-4,1.47×10-4,1.85×10-4/mW对应样品分别为0,2,4,6个周期的样品,数据显示6个周期的量子点样品具有最高的室温辐射效率,它的辐射效率是传统InAlAs缓冲层上生长InAs量子线辐射效率的1.5倍.说明引入缺As的InAlAs层不会在材料中引入非辐射复合中心.为了进一步评价4个样品中InAs纳米结构的尺寸均匀性,分别测了4个样品在15 K时的PL谱(图 3(b)).从图 3中室温和低温PL谱中,可以看到对于0个周期的样品,PL谱的谱型含有多峰结构,其他3个样品的峰谱型都表现为高斯型分布.室温变功率PL谱(图 4)显示,随功率增加4个样品的谱型没有变化,可认为零个周期样品PL谱的多峰结构及其他3个样品谱型都是由于InAs纳米结构尺寸波动引起的,因此窄的半高宽表明InAs纳米结构尺寸的均匀性.
本实验中,4个样品的PL谱的半高宽分别为:108,124,138,116 meV,分别对应于0,2,4,6个周期的As压调制的InAlAs超晶格.数据显示传统的InAlAs缓冲层上生长的InAs量子线结构的低温半高宽最小,表明在本研究采用的生长条件下,InAs量子线的尺寸分布较均匀.引入了6个周期的As压调制的InAlAs超晶格样品的低温PL谱的半高宽仅次传统的InAlAs缓冲层上生长的InAs量子线结构的PL谱的半高宽,这表明本研究所设计的超晶格有利于提高InAs纳米结构尺寸均匀性.在图 3中还能发现,2个周期的样品的PL谱的半高宽比4个周期时的窄,而前面AFM像却显示2个周期时InAs纳米结构的尺寸分布较大,量子线和量子点都有出现,而4个周期时形成椭圆型的量子点,尺寸分布较2个周期时小.我们认为这种AFM结果和PL数据的不一致可能与InAs纳米结构的空间分布不同有关.从图 2中的AFM像可以看出,4个周期时InAs量子点的密度较低,它们以较大的间距分散开,这意味着量子点中电子将难以在不同的点之间隧穿或者通过浸润层相互转移;因此在此体系中,一些量子点中的光生载流子尽管能级位置较高,也不能转移到其他量子点中的较低能级去.相比之下,2个周期时形成InAs量子线和量子点,量子线中的电子分布就很可能达到近热平衡状态,这就相对地缩小了电子分布的能量范围.相应地,较窄的光跃迁能量范围体现在PL谱中为较窄的半高宽[12].最后,我们还研究了6个周期的样品的PL强度随温度的变化并和典型的InAs/GaAs量子点的强度进行了比较(图 5).结果显示6个周期样品中量子点PL谱强度随温度增加衰减的速率明显低于InAs/GaAs量子点PL强度衰减速率.在测量的温度范围内,对于有6个周期的As压调制的InAlAs结构的样品,其PL强度只衰减了不到6倍,而作为比较的GaAs系统其PL强度衰减了近66倍.一般认为随温度的升高,量子点中的载流子逐渐克服热势垒逃逸到浸润层或势垒层中,并在那儿进行辐射复合或非辐射复合,这是量子点发光强度淬灭的主要原因.量子点PL强度随温度变化的关系式为[13]
其中:I(0) 为量子点最大PL强度,E1和E2为激活能,k为玻尔兹曼常数,T为温度.
定量公式表明:量子点的限制势垒越高,激活能越大,PL强度衰减得越慢.因此在本文中低的PL强度淬灭速率一方面说明本文样品中量子点有较高的限制势垒,在一定程度上可抑制载流子的热逃逸,进一步证实引入缺As的InAlAs不会产生非辐射复合中心;另一方面也说明缺As的InAlAs层的引入不但不会引入非辐射复合中心反而会使量子点中的非辐射复合渠道大大减弱.
-
InAlAs/InP(100) 系统中,InAs纳米结构的形貌和光学特性受到InAlAs层生长条件的明显影响. As压调制的InAlAs超晶格能有效地调整InAs纳米结构的形貌特性、发光峰位,辐射效率及尺寸分布和相应的半高宽.随着进一步优化生长条件:改善超晶格各层的厚度、周期数及As压大小,可以进一步提高量子点尺寸均匀性.我们相信在InAs/InAlAs/InP系统中可以得到更高结构质量、更窄发光线宽的InAs量子点,从而有利于其在长波长光电器件特别是量子点激光器方面的应用.



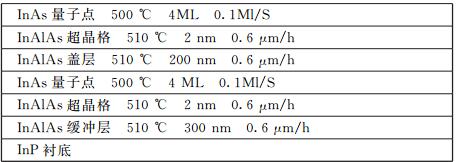
 下载:
下载: